Низкотемпературная плазма – это слабоионизованный газ, состоящий из нейтральных атомов и молекул и заряженных частиц (ионов и электронов). Данное состояние вещества достигается посредством газового разряда. Сложность полного описания газовых разрядов из базовых физических принципов делает низкотемпературную плазму интересным объектом фундаментальных физических исследований как теоретических, так и экспериментальных. В лаборатории физики плазмы исследуются объемные и поверхностные процессы в разрядах постоянного тока, высокочастотных и СВЧ-разрядах в различных атомарных и молекулярных газах с помощью оптических, зондовых и масс-спектрометрических методов измерения параметров плазмы, а также разрабатываются численные модели газовых разрядов и элементарных процессов в плазме.
Большинство этапов производства современных микро- и наноструктур (в микроэлектронике, микромеханике и т .д.) предполагает использование газовых разрядов низкого давления. Постоянное уменьшение размеров структур и усложнение их топологии требует проведения физических исследований при внедрении новых технологических процессов. Лаборатория физики плазмы в сотрудничестве с ведущими мировыми исследовательскими центрами и технологическими компаниями занимается исследованиями таких проблем как предотвращение плазменной модификации новых материалов в процессе производства микросхем, плазменная очистка зеркал, применяемых в современных литографах и др.
Руководитель направления: профессор, д.ф.-м.н. Рахимов Александр Турсунович
Руководитель теоретической группы: в.н.с., к.ф.-м.н. Рахимова Татьяна Викторовна
Руководитель экспериментальной группы: в.н.с., к.ф.-м.н. Лопаев Дмитрий Викторович
Исследование объемных и поверхностных процессов в неравновесной низкотемпературной плазме при взаимодействии плазмы с современными материалами микроэлектроники.
Структурирование поверхности твердотельных пластин с применением низкотемпературной плазмы является одним из основных высокотехнологичных процессов производства современных интегральных микросхем (СБИС). В настоящее время исследование процессов, определяющих характер структурирования поверхностей, направлено на продвижение использования плазмы в область создания структур с размером близким к атомарному, т.е. порядка нескольких нанометров. Среди этих исследования одним из ключевых звеньев в создании СБИС следующего поколения является разработка бездефектного плазменного травления материалов с ультранизкой константой диэлектрической проницаемости (ULK). Анизотропное травление таких материалов в современной микротехнологии осуществляется с помощью низкотемпературной плазмы высокочастотных (ВЧ) разрядов в смесях фторуглеродов и фторуглеводородов. Под действием активных реагентов плазмы (атомы фтора и фотоны в области вакуумного ультрафиолета (ВУФ)) такие диэлектрики модифицируются, что приводит к ухудшению электрических свойств диэлектрика (токи утечки, увеличение диэлектрической проницаемости и т.д.). Зачастую, экспериментальное исследование свойств такой сложной плазмы и получение потоков активных частиц из плазмы на поверхность обрабатываемого материала в условиях реальных технологических установок практически невозможно. Поэтому на кафедре созданы специально разработанные экспериментальные установки, оснащенные оригинальными диагностическими средствами, позволяющие детально исследовать плазмохимические процессы, что позволит прогнозировать разработку технологических плазменных реакторов следующего поколения.
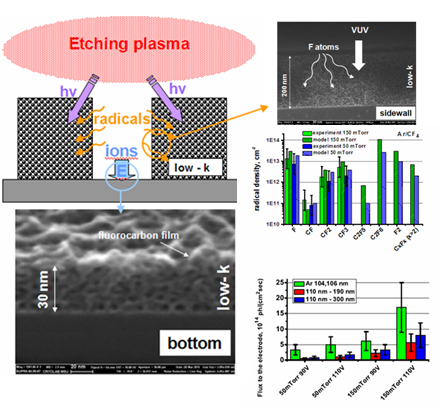
В ходе исследований было проведено измерения большого числа параметров плазмы (концентрации электронов, отрицательных и положительных ионов) и концентрации различных нейтральных частиц в ВЧ емкостной плазме CF4/Ar и CHF3/Ar, а также поток излучения плазмы в ВУФ и УФ диапазонах, наиболее важных с точки зрения деградации новых диэлектрических материалов. На основании проведенных измерений, а также расчетов с помощью самосогласованной модели частиц в ячейках с Монте Карло столкновениями были получены или верифицированы константы скоростей реакций, определяющих ионный состав данных смесей, получены концентрации основных радикалов и поток ВУФ излучения, подтверждено существование двух мод разряда в зависимости от электроотрицательности плазмы. Экспериментально показано, что воздействие плазмы фторуглеродов на нанопористые ULK диэлектрики приводит к их деградации, в основном, за счет радикалов фтора и ВУФ фотонов из плазмы. Обнаружено, что как модификация материала в реакциях с фтором, так и травление материала обладают энергией активации. Тем самым, травление и деградация материалов сильно зависит от температуры образца. Кроме того, было показано, что присутствующий в большинстве травильных смесей аргон вносит большой вклад в интенсивность ВУФ излучения плазмы.
Предложен многостадийный механизм повреждения и травления ULK органосиликатных пленок атомами фтора (удаление метильных -CH3 групп) и проведены детальные динамические и статические расчеты отдельных реакций механизма методом функционала плотности (DFT). DFT расчеты позволили выявить возможную причину существенно более быстрого травления фтором ULK пленок по сравнению с обычными SiO2 пленками. Экспериментальные измерения гибели метильных групп при разных температурах пленок и проведенные расчеты (по 1-D Монте-Карло модели) позволили найти энергию E активации реакции Si-CH3 + F → Si-CH2 + HF.
Моделирование плазменного травления low-k диэлектриков
Основная задача компьютерного моделирования – выявление механизмов взаимодействия частиц плазмы (атомов, молекул, атомарных и молекулярных ионов) с поверхностью ULK диэлектриков для разработки технологии плазменного травления подобных материалов с минимизацией повреждения СН3 групп. В общем случае процессы взаимодействия ULK диэлектриков с плазмой относятся к различным пространственно-временным масштабам (время взаимодействия отдельных атомов друг с другом составляет единицы-сотни фемтосекунд, для релаксации дефектов требуются значительно более длительные временные интервалы, а сам процесс травления пленки толщиной в 100-200 нм может происходить за сотни и тысячи секунд в зависимости от условий разряда в плазме), поэтому при исследований указанных процессов необходимо применять методы многомасштабного моделирования (multiscale simulation).
Ab initio методы ("из первых принципов")
- Расчет межатомных парных и многочастичных потенциалов для последующего использования при моделировании методом молекулярной динамики и в моделях Монте-Карло
- Изучение особенностей структуры и электронного строения 2D материалов (графен, MoS2, h-BN) и других наноразмерных объектов (углеродные и борнитридные нанотрубки, наночастицы различного состава и т.д.)
- Моделирование химических реакций на поверхности ULK материалов
- Использование современных программных комплексов: MOLPRO, VASP, NWChem
Молекулярная динамика
- Изучение особенностей структуры ULK материалов с использованием потенциалов, полученных с помощью ab initio методов
- Физическое и химическое процессов распыления пористых ULK диэлектриков и наноструктур
Метод Монте-Карло
- Процессы травления low-k материалов
- 2D и 3D модели плазмохимических реакторов с активацией сложных газовых смесей ВЧ, СВЧ, DC и dc arc-jet разрядами
- Химическая кинетика, тепло- и массо-перенос, поверхностные процессы
Большинство расчетов производится на суперкомпьютере «Ломоносов» суперкомпьютерного комплекса МГУ.